作为大功率,高频和高效电力电子的理想选择,SiC MOS近年来为越来越多的行业所接受。器件选型时相对于性能应用端更关注SiC MOS的长期可靠性,从而确保客户端零失效。栅氧质量是决定SiC MOS 长期可靠性的核心要素之一,介电层击穿(Time Dependent Dielectric Breakdown,简称TDDB)和E-模型(E-Model)是表征MOS栅氧长期可靠性的两大核心工具。本文介绍如何通过TDDB和E-模型来评估各类优化的有效性,进而确保SiC MOS长期可靠性。
TDDB测试和E-模型拟合:SiC MOS栅氧寿命评估
目前业界已量产SiC MOS其栅氧(Gate oxide)均为SiO2,在SiC表面生长高质量栅氧一直是各友商的核心积累。TDDB是评估MOS栅氧寿命的标准手段,在温度和电场的作用下栅氧被击穿所用时间为栅氧寿命,一般采用63.2%的器件被击穿时间(简称t63%)进行寿命评估,根据需要也可采用其他时间如t1ppm(百万分之一器件被击穿所用时间)。TDDB为破坏性测试,如果在MOS 正常工作Vgs use电压和温度条件下对器件进行TDDB测试,则所需时间漫长基本上以年为单位。行业的标准做法是在高温(如器件目标结温)和高电场下对器件进行加速老化测试得到器件寿命,然后对相同温度三组不同电场下的寿命进行E-模型拟合,从而推导出正常工作区间下(即驱动电压Vgs,use的允许范围)器件寿命。
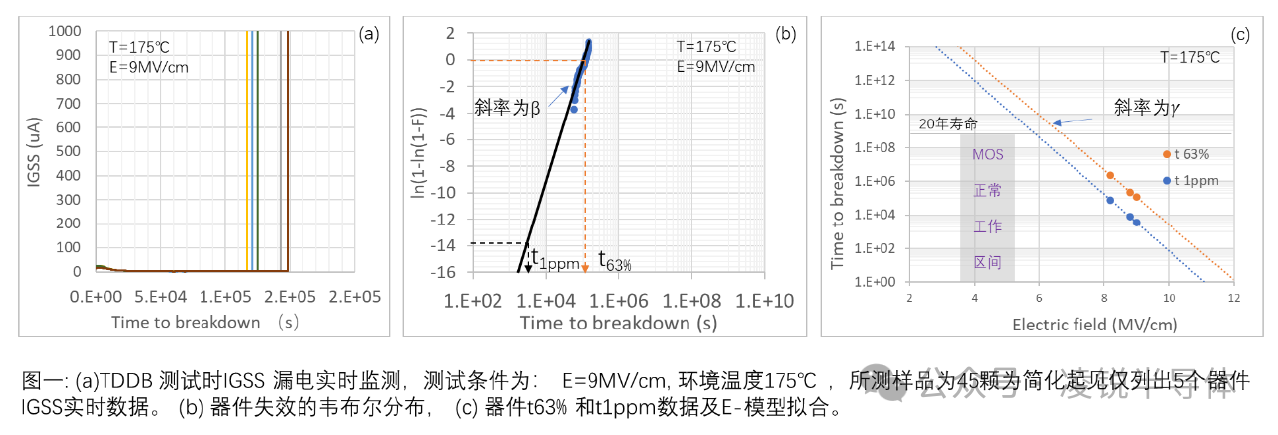
图一通过具体案例说明如何用TDDB测试和E-模型拟合推导SiC MOS在Vgs use下的寿命。如图一(a),在175℃(产品规格书Tjmax)的环境温度下对一组SiC MOS样品(45颗)同时在栅氧上加9MV/cm的电场,IGSS漏电随时间一开始保持不变,当高温和高电场的作用达到一定时间时栅氧被击穿IGSS 显著迅速增加。统计每个样品的失效时间并进行韦布尔分布处理即得到图一(b),对图一(b) 数据拟合可得出器件在不同失效率(如1 ppm)下器件寿命。对三组不同电场下的器件寿命进行E-模型拟合可得到图一 (c),根据拟合的曲线可计算出MOS 正常工作区间内器件寿命。
图一案例有一个非常理想的假设:SiC MOS栅氧本身不存在缺陷。实际量产的SiC MOS 总会有漏网之鱼即少量SiC MOS栅氧存在缺陷。无缺陷SiC MOS栅氧寿命为本征(intrinsic)寿命,由栅氧缺陷导致的器件寿命为非本征(extrinsic)寿命。根据木桶效应,栅氧缺陷对器件寿命和应用端失效率的影响至关重要。

如何降低栅氧缺陷及其负作用是一门工程艺术,是各友商多年的积累。图二本征部分代表器件本征栅氧寿命分布,非本征部分为栅氧缺陷导致的寿命分布。SiC MOS栅氧缺陷又分为致命缺陷和非致命缺陷,致命缺陷对应的栅氧寿命低于芯片目标寿命。
SiC MOS栅氧非本征早期失效:栅氧局部等效减薄模型
很多制造环节如外延缺陷,生长栅氧所用仪器状态,化学清洗等环节均可导致栅氧缺陷存在,进而导致器件早期失效。对于栅氧缺陷导致的器件寿命降低,业界一般采用栅氧局部等效减薄模型进行解释。
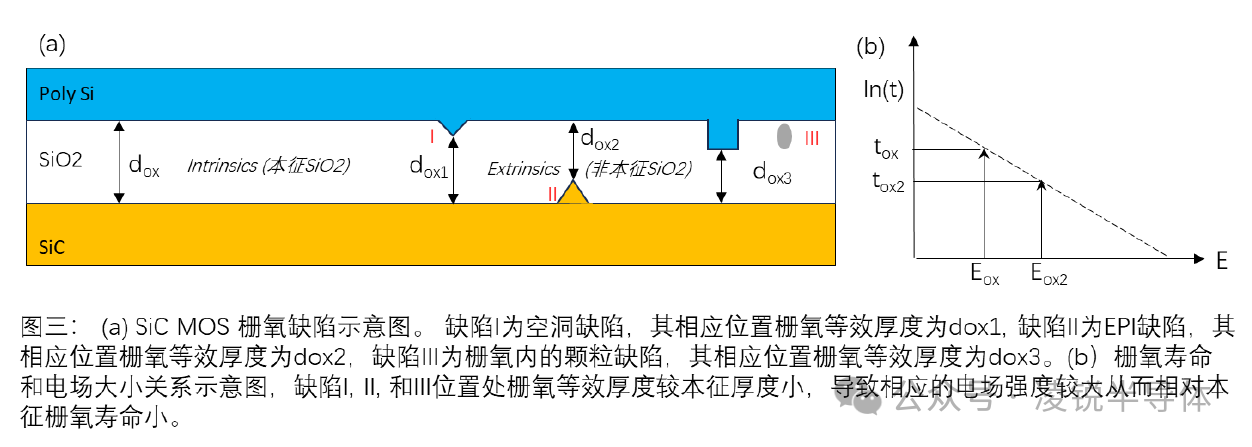
参见图三(a),SiC MOS栅氧位于多晶硅(poly Si)和SiC之间。左半部分栅氧没有缺陷为本征栅氧,右半部分列出三类缺陷为非本征栅氧。缺陷I 为空洞缺陷,缺陷II 为SiC EPI缺陷,缺陷III为栅氧中颗粒缺陷。栅氧寿命和电场强度的关系参见图三(b)。电场强度越大则栅氧越容易击穿其寿命越小。由缺陷引起的早期失效可用栅氧局部等效减薄来解释,参见图三 (a),当栅氧上加上Vgs偏压时,由于缺陷处栅氧等效厚度的减小相应位置电场强度(E=V/d)增大,导致器件寿命降低(非本征失效)。图三仅列举了栅氧中存在缺陷的三个例子,在实际场景中也会存在其他类型的栅氧缺陷。
由此可见,提高SiC MOS栅氧本征寿命固然重要,更重要的是如何管控栅氧缺陷密度,有效的进行栅氧缺陷筛选,从而确保客户端“零失效”。
SiC MOS器件筛选的理论基础:韦布尔常数β≈1
本章节公式为进行TDDB定量分析必不可少的基础。依据这些理论对测试数据进行变换和推演可获得很多关键信息。

公式(1)为器件累计失效分布函数(cumulative distribution function of the time-to-failure),表示到时间t时器件累计失效的概率,



