2026年初,英伟达创始人黄仁勋的中国行一举成为科技行业热议焦点,坊间更有业内消息透露,其此次行程的核心诉求之一,便是为英伟达下一代芯片寻找高端散热的终极解决方案。尤其是黄仁勋与河南超赢钻石科技的会面,更是被业界敏锐地捕捉到关键信号——这位“算力霸主”正在急切地寻找能够驯服下一代GPU狂暴热流的终极方案 。
这一动作并非空穴来风,早在CES 2026上,英伟达已明确宣布下一代Vera Rubin架构GPU将全面采用“金刚石铜复合散热+45℃温水直液冷”方案,为全球高端芯片散热技术路线定下基调。
AI算力狂飙下的散热危机
为何英伟达会为一种材料投入如此多的精力与资源?答案或许藏在AI算力狂飙背后的散热危机中。
近年来,AI大模型训练与推理需求推动芯片晶体管密度和运行频率持续提升,热量堆积已成为制约算力释放的核心瓶颈——温度每升高10℃,电子设备可靠性下降50%,超过35%的电子设备故障源于过热,而AI数据中心中40%的能耗都用于散热。
在AI算力指数级飙升的当下,这场“寒战”的爆发似乎早已注定。
随着Blackwell架构GPU功耗突破1000W,Rubin架构芯片更是向1500W以上迈进,部分型号峰值接近2300W,芯片局部热流密度超1000W/cm²,传统散热方案对此早已力不从心。
例如风冷技术受限于空气导热系数,在热流密度超300W/cm²时完全失效;传统液冷虽有提升,但热传递路径长、热阻大,无法匹配Rubin架构芯片的高热流需求。更关键的是,传统纯铜材料存在先天缺陷:热导率仅400W/(m·K),且热膨胀系数(CTE)高达16.5-17.5×10⁻⁶/K,与硅基芯片膨胀系数(3-4×10⁻⁶/K)、宽禁带半导体(4-5×10⁻⁶/K)差异显著,温度循环中易产生热应力,导致封装层疲劳、焊接界面断裂。
钨铜、钼铜等合金材料虽能通过成分调整将CTE调控至6.5-7.5×10⁻⁶/K,却牺牲了导热性能,热导率仅180-210 W/(m·K),陷入导热与匹配不可兼得的困境。
可见,传统散热已触及物理极限,无法匹配超高功率芯片的散热需求。英伟达亟需通过“局部核心极致散热+全局高效控温”的多重架构来支撑芯片功率的进一步突破。
金刚石铜降维打击,
突破散热极限
金刚石铜复合材料的出现,实现了技术维度的降维打击。
据了解,金刚石铜的核心优势在于超高热导率与精准可调的热膨胀系数的双重保障。金刚石理论热导率可达2200 W/(m·K),与铜复合后,材料热导率可提升至600-1000 W/(m·K)以上;同时通过调整金刚石颗粒的体积分数与微观分布,可将CTE精准调控至5-7×10⁻⁶/K,与SiC、GaN等主流半导体材料及芯片-PCB板组合高度契合。”
这种特性使其能从根源上解决散热痛点:一方面快速传导高热流密度热量,避免芯片局部过热;另一方面大幅降低泵出效应,减少材料翘曲和界面间隙,从系统层面提升散热可靠性。在功耗超700W的AI GPU、高密度封装的HBM以及超算芯片等场景中,金刚石铜已成为无可替代的最优解。
“散热不再是性能优化项,而是定义产品上限的战略资源,”华太电子全资子公司华智新材料的散热专家表示,“当芯片功耗突破千瓦大关,传统散热方案带来的性能降频、寿命缩短、能耗激增等问题已无法容忍,金刚石铜从高端散热的‘可选方案’升级为‘必选项’,成为行业发展的必然。”
黄仁勋与散热方案供应商的会谈,以及Rubin平台一次性发布了六款芯片,部分芯片尺寸预计达到甚至超过100mm*100mm,更印证了这一趋势——大芯片的散热升级不能仅靠金刚石铜替代传统铜的材料替换,必须从系统整体层面优化。
英伟达的布局不仅是为当前芯片降温,更是为下一代3D封装、高功率密度芯片铺路,而金刚石铜正是这一战略的核心支撑。
随着英伟达方案的公布,业界的猜测焦点从“用什么”转向了“怎么用”——金刚石铜究竟用于与芯片直接接触的一级封装(散热盖/热沉),还是系统级散热的二级封装(液冷板)?
从技术逻辑来看,一级封装的核心价值在于直接与芯片接触降低结温,对材料的热膨胀系数匹配性和界面结合质量要求极高。一级封装需要材料既能快速导出芯片核心热量,又能适应温度循环中的应力变化,避免损伤芯片,传统纯铜的均热能力已无法解决大尺寸SoC芯片的单点局部过热问题;二级封装更侧重系统级热量扩散,与冷板结合实现全域散热,对加工精度和成本控制更为敏感。
“英伟达可能采用一级+二级的整合方案,” 华太电子从行业供应链角度给出了明确的判断与技术预判:一级与二级封装的整合创新是终极方向,但现阶段需遵循成本与性能协同优化的原则。
据悉,英伟达尝试在硅片上制作微流道,并计划将金刚石铜散热盖同步制成微流道结构,实现“芯片-散热盖-液冷”一体化设计。这一整合方案是对传统CoWoS封装散热体系的彻底优化:传统CoWoS封装存在热界面材料(TIM1、TIM2),且硅芯片与冷却液之间有盖板阻隔,多重界面大幅增加了热阻,限制了冷板对芯片热点的散热能力;而集成式硅片直冷方案,通过在硅芯片背面蚀刻微流道,并采用密封材料将金刚石铜微流道盖板与封装无缝连接,直接消除了冷却液与硅片之间的阻隔界面,实现了更高热流率的高效散热。但焊接工艺复杂度和芯片可维护性可能是需要克服的关键挑战。
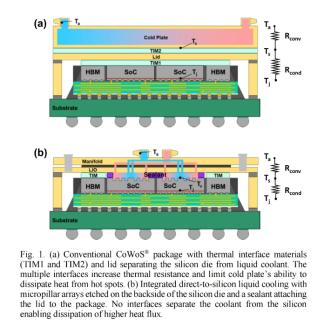
华太卡位AI散热风口,
构建全场景散热图谱
针对英伟达可能的技术路径,华太电子全资子公司华智新材料早已形成“双轨并行”的布局策略,且均已进入客户送样与性能验证阶段,形成了显著的先发优势。
在一级封装层面,华太电子已完成关键仿真验证,结果显示金刚石铜相比纯铜优势显著。其工艺端已布局针对性的焊接解决方案,通过对金刚石铜局部金属化处理,采用软焊料与芯片背面焊接,能快速导出核心热量。华太电子强调,这种方案能有效解决大芯片局部过热,实现热量的快速均匀传导。
在二级封装层面,华太电子提出了更具可行性的局部嵌装方案:在高热流密度区域内嵌金刚石铜材料,再通过液冷板的微流道完成热量全域传导。这种设计兼顾了性能提升与成本控制,是二级散热环节的核心优化路径。
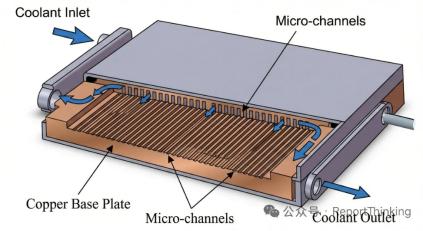
图源:ReportThinking
作为一家从射频业务起家的公司,华太电子布局金刚石铜的跨界逻辑,源于其长期的工艺积淀与对市场需求的精准洞察。
据了解,华太电子的金刚石铜业务最早聚焦于大功率射频功放(PA)的一级热沉。彼时碳化硅基氮化镓器件进入小批量量产,传统散热材料已无法满足其高功率散热需求,华太率先实现了金刚石铜在该领域的应用。正是射频PA对散热近乎苛刻的要求,倒逼出了华太在金刚石铜界面改性、表面处理及精密加工上的核心技术积累,已打造多系列产品矩阵,完成多项核心专利申报。
据华太电子介绍:“我们的发展路径是从具体需求出发,逐步拓展场景,最初聚焦大功率射频功放的一级热沉,随后拓展至数字芯片散热盖,再到二级热沉的水冷板方案,形成了完整的技术演进脉络。”
如今,华太电子依托旗下核心主体佛山华智新材料有限公司,已构建起覆盖低、中、高端全场景的散热材料矩阵,产品线既包含钼铜、纯铜、金刚石铜等非绝缘散热材料,也布局了氮化硅陶瓷等绝缘导热材料,同时掌握金属扩散焊、CPC工艺、微流道加工等核心工艺,完成了从材料研发到工艺落地的全链条布局。
其中在金刚石铜领域实现关键突破,通过表面金属化与铜基体合金化的双重处理技术,大幅提升了材料界面热输运效率,其量产级金刚石铜产品热导率稳定在800W/(m·K)左右,兼具优异的抗热冲击性能,整体技术水平处于国内第一梯队,也成为国内较早实现金刚石铜量产及商业化落地的企业之一。
在产品落地与应用布局上,华太电子实现了金刚石铜一级、二级封装双方案全覆盖:一级封装的散热盖/热沉产品,采用局部金属化与软焊料焊接工艺,可有效解决大尺寸SoC芯片局部过热问题,目前已在数字芯片领域批量供货;二级封装的液冷板产品则采用局部嵌装设计,在高热流区域内嵌金刚石铜,实现散热性能与成本的平衡,相关产品已完成客户送样验证。
整体来看,从射频PA到AI芯片,华太电子的散热方案已实现全场景适配:针对碳化硅、LDMOS等功率芯片,结合旗下瑶华工厂的封装能力打造专属热沉解决方案;针对数字芯片、算力芯片,提供从一级热沉到二级液冷的一体化散热方案;针对高端装备4000W功率、2000W功耗的极端散热需求,还研发了金刚石铜微流道液冷方案,目前该方案已进入技术论证阶段。
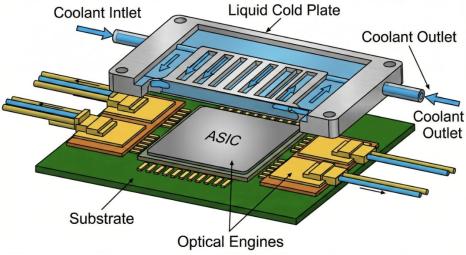
图源:ReportThinking
全栈式的产品与方案布局,让华太电子在AI散热赛道形成了显著的先发优势。
商业化瓶颈:
技术、成本、生态协同的三重挑战
尽管金刚石铜赛道热度高涨,但行业普遍认为其在数据中心的应用尚处于“早期验证阶段”,大规模商用扔面临多重瓶颈。华太电子指出,制约其落地的核心因素集中在技术、成本及产业链协同三大维度:
技术层面,三大难题制约产业化推进:一是金刚石与铜本质上不浸润,如何改善金刚石和铜的界面热阻是技术核心。若界面过渡层未达预期,热导率会大打折扣,甚至不如纯铜;二是大尺寸产品的性能均匀性,金刚石铜复合材料在尺寸增大后易出现局部性能偏差;三是精密加工难度,金刚石的高硬度导致加工成本居高不下。
成本层面,金刚石原材料价格约为纯铜的8-10倍,叠加加工成本,让很多中低功耗场景望而却步。
产业链层面,从材料供应到芯片设计、封测、系统集成的协同体系尚未成熟,缺乏统一的可靠性评价标准,验证周期漫长。
面对这些挑战,华太电子已实现多项核心突破:
1)攻克界面结合难题,实现性能突破:针对金刚石与铜界面改性问题,通过金刚石表面金属化处理与铜基体合金化处理的双重技术手段,让界面过渡层达到理想的结合状态,界面热输运效率大幅提升,性能指标已接近理论值。目前其量产级金刚石铜产品的热导率稳定在800W/(m·K)左右,同时具备优异的抗热冲击性能,整体技术水平处于国内第一梯队。
2)优化工艺与产线,改善均匀性、降低成本:通过研发多梯度烧结工艺,有效解决了大尺寸产品的性能均匀性问题;同时搭建金刚石铜专用加工线,大幅降低了材料的加工难度与制造成本,实现了产品性能与成本的双向优化。
3)加速供应链国产化,规避卡脖子风险:华太金刚石铜业务的整个供应链体系均实现国产化布局,核心原材料、加工设备、工艺技术均无对外依赖,从根源上规避了供应链卡脖子风险,保障了产品量产的稳定性与可持续性。
基于上述技术突破与供应链布局,构成了华太电子在金刚石铜产品现阶段最核心的市场竞争优势。
此外,华太电子的竞争力更在于其独有的产业链闭环优势。作为芯片设计企业,华太能将金刚石铜产品在自有芯片体系中进行先导性验证,产品导入、迭代和研发效率远超行业友商。这使得华太电子不仅是材料供应商,更是一站式散热解决方案提供商。
面对全球金刚石铜市场由日本住友电工、美国元素六等海外巨头主导的格局,华太电子认为,中国企业在成本方面具备全球领先的先天优势,加上完善的制造业配套,基础优势显著。
对于国产替代的路径,华太电子指出国内厂商应聚焦三大核心方向:一是开展核心技术联合攻关,聚焦界面热阻控制、精密加工等共性瓶颈实现突破;二是携手制定统一的行业技术标准与产品规范,推动行业规范化发展,探索更成熟的成本管控体系;三是深化全产业链开放协同,整合技术、产能与资源优势,合力打造适配AI算力时代的高端散热解决方案。
在这场由英伟达引领的散热革命中,国产力量不仅要实现替代,更要让“中国方案”成为全球金刚石铜散热领域的核心力量。“在这条赛道上,我们的定位是全球高端金刚石铜供应商,既要做国产替代的领军者,也要聚焦AI核心赛道打造差异化方案”华太电子表示。
掘金AI散热蓝海,
中国方案的全球野心
展望未来,金刚石铜正从概念验证逐渐迈入规模化商用的关键时期。开源证券研报指出,2026年2月,首批搭载金刚石散热技术的服务器已完成商业化交付,标志着产业化落地节奏明显加速,2026年有望成为金刚石在AI领域应用的0-1产业化拐点之年 。
据行业预判,数据中心将成为金刚石铜最重要的蓝海市场,未来几年需求将迎来爆发式增长,市场前景愈发清晰。
对此,华太电子已制定针对性规划:沿着从射频功放一级热沉向液冷、系统级封装延伸,从单一芯片/器件散热向系统级散热解决方案延伸的核心方向推进,紧跟芯片封装技术演进趋势,从2.5D/3D封装到Chiplet架构,同步升级金刚石铜产品——从单层小尺寸热沉片,拓展至风冷、水冷微通道复合方案;从标准化产品,升级至异形结构件和复杂微观结构产品,实现与客户场景的精准匹配,打造一体化系统级散热解决方案。
能看到,华太电子的愿景,是凭借材料革新与方案创新,破解大芯片与AI算力发展中的散热瓶颈。在这场决定未来算力格局的“寒战”中,华太电子正以全栈式的技术布局、量产落地的先发优势,以及开放协同的合作姿态,全力抢占AI散热蓝海市场的核心席位,推动国产高端散热材料实现从跟跑到领跑的跨越。



